9月14-15日,2023全球AI晶片峰會(GACS 2023)在深圳正式舉行。 奎芯科技應邀出席大會,副總裁王曉陽發表主題為《驅動雲/邊緣側算力建設的高性能互聯接口方案》的演講。 在演講中,王曉陽分享了AIGC產業算力需求引發的晶片互聯趨勢,並對算力晶片瓶頸進行了分析,提出了奎芯記憶體互聯解決方案和Chiplet方案落地案例。
AIGC引爆的晶片互聯趨勢
最近幾年AI模型快速發展,模型規模每年差不多10倍速度增長,當令人驚訝的1750億參數的GPT3已成為過去式,迎來更大體量的萬億參數時代,AI系統算力需求也隨之新增,幾乎每季度翻倍增長。 最近幾年體系結構討論最多的問題之一就是如何破解兩堵牆:記憶體牆和I/O牆。 多年來通過工藝進步,計算架構設計革新等方法,理論算力的增長速度是驚人的,但是記憶體頻寬,互聯頻寬的增長卻相對緩慢,造成了巨大的落差,最近業界也在嘗試很多方法來縮小這些差距比如:新增緩存,多級緩存架構,堆疊緩存; 儘量提高單節點算力减少互聯的overhead; 用高速的晶片互聯和系統互聯的SerDes做晶片互聯等等。

NVIDIA GH200非常重點的強調HBM頻寬,LPDDR容量,以及NVLINK的速度。 AMD發佈的MI300X對算力名額尚未提出,只提記憶體容量、記憶體頻寬以及互聯頻寬。 囙此可以看到在LLM的遊戲規則下,記憶體容量、記憶體頻寬以及互聯頻寬成了最核心的競爭力,而算力的重要性相對下降。
算力晶片瓶頸分析
現時主流AI大晶片採用HBM為主,它的價格相對其他記憶體要貴,但組織頻寬成本較低。
HBM使用有諸多限制,其一是因為HBM的顆粒必須和SOC的Die要對齊,合封在一起,所以它是一個緊耦合的狀態,會帶來如下限制:在HBM數量方面,SoC與HBM必須保持貼合,導致HBM顆粒數量受限於晶片邊緣長度; 在熱管理方面,DRAM的溫度敏感性會限制SoC的工作頻率,從而影響效能,而SoC與HBM之間的熱互動對測試提出了更高的要求; 在設計實施方面,HBM IP的佈局和適配性相對不够靈活; 另外,工藝限制要求SoC與HBM HOST IP必須採用相同的工藝制程; 最後,需要注意的是SoC的面積佔用問題,在12納米工藝下每個HBM HOST IP大約佔據30mm2,限制了計算單元的面積。
其二是主流HBM的應用還是以先進封裝為主,包括Silicon interposer或者Silicon Bridge等,也帶來了不少限制:Interposer尺寸受限制,最大只能有3到4個曝光面積; 2.5D封裝的成本較高,與標準封裝相比價格高出4倍,近期台積電的CoWoS單價上漲了20%; 採用uBump作為連接點時,測試覆蓋率有限,當封裝中包含超過6個HBM和2個ASIC時,良率明顯下降; 最後,CoWoS產能有限,台積電的CoWoS產能緊缺,2.5D封裝技術還不够成熟。
奎芯基於UCIe介面的HBM互聯方案
針對這些問題,奎芯科技打造一站式解決方案—M2LINK,用於將HBM和SoC解耦。 基本做法是利用一顆Chiplet將HBM介面協定轉成UCIE介面協定,然後用RDL interposer把Chiplet和HBM記憶體封裝成一個標準模組,最後通過普通基板來和主SoC進行封裝。 這樣主SoC和標準模組間距離預計可以拉遠到2.5cm,克服了原先主SoC和HBM緊耦合和綁定的限制,同時也無需受限於先進封裝的高成本和Si Interposer的有限尺寸。 除此之外還有諸多好處,比如以UCIe IP取代HBM IP,節省了主晶片面積,主晶片成本降低; 組織邊長可以連接更多的HBM標準模組,記憶體容量和頻寬都可以得到提升等等。

以現時主流晶片為例,SoC近HBM的邊長為30mm的話,可以擺放6個HBM顆粒,利用M2LINK方案的話,雙邊共可以擺放8個HBM模組,同等大小的SoC可利用面積增大44%,記憶體容量頻寬新增1/3,最大封裝面積可以新增一倍以上。
奎芯Chiplet落地解決方案
奎芯科技作為互聯IP產品及Chiplet產品供應商,自研記憶體及互聯解決方案,奎芯LPDDR5X介面速率可達8533Mbps,業界領先。 奎芯D2D介面則具有高速率、低功耗、低延遲等優勢。 而奎芯HBM介面可支持工藝PHY+ Controller全套方案,速率可達6.4Gbps。 現時,奎芯已經有70件智慧財產權申請,以及16件榮譽獎項。

奎芯科技基於對於整個封裝供應鏈的綜合能力,現時和客戶一起打造一款標準的帶HBM3的2.5D封裝大晶片,將會提供包含HBM IP,interposer設計,2.5D封裝的設計的完整的turn key solution。
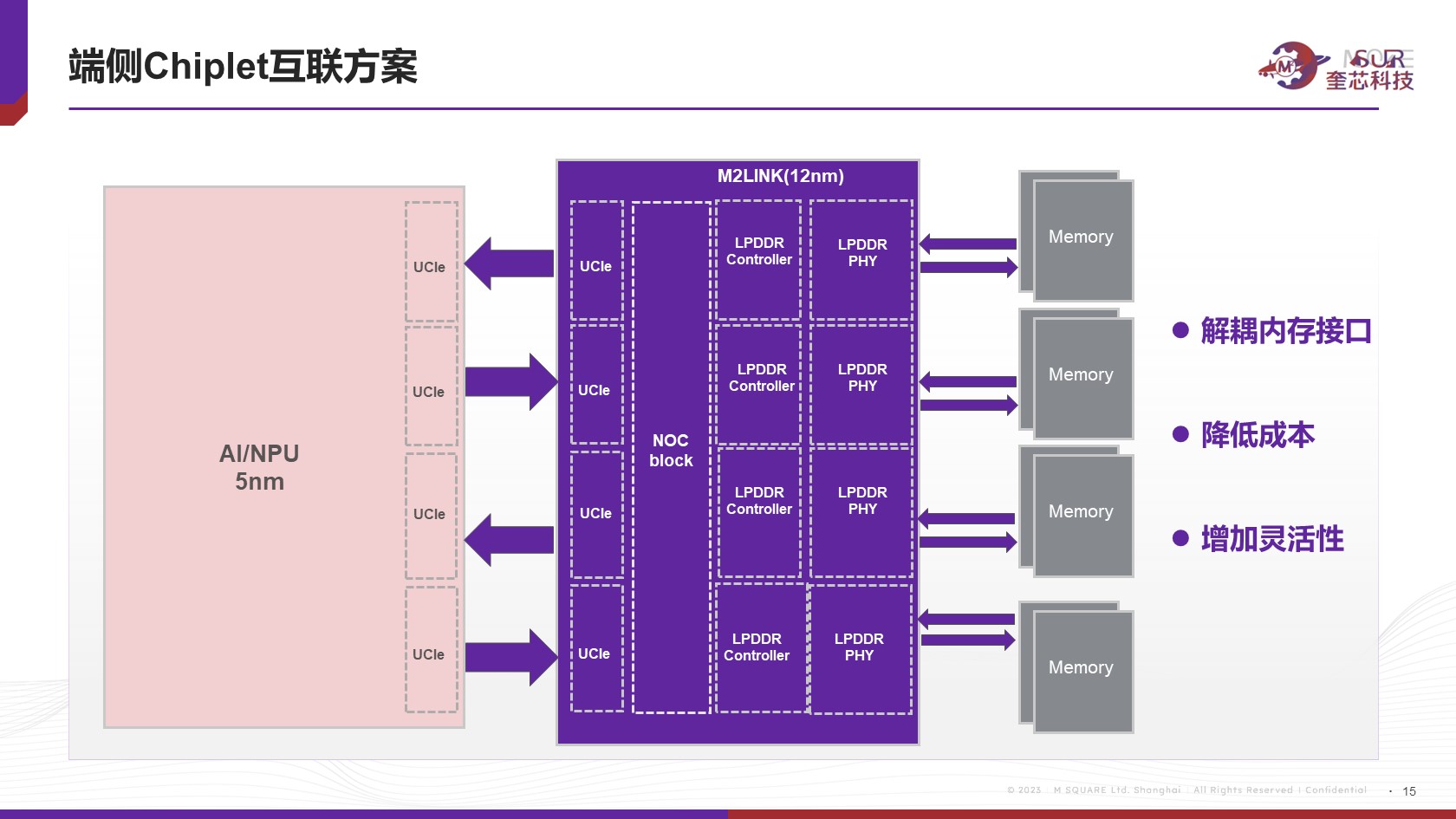
同時,奎芯科技基於D2D(UCIe)解耦SoC和HBM HOST的思路不僅適用於雲端訓練和推理的大算力晶片,在端側已經有具體實踐的案例,現時在給客戶打造的是一款低功耗計算產品的IO die。 對於此場景,客戶希望計算部分用最先進的制程,考慮到昂貴的成本,客戶還是希望解耦記憶體介面放到成熟工藝上實現,囙此我們給客戶打造一顆包含LPDDR host的完整IO die,實現記憶體介面解耦,降低成本,為客戶未來產品升級新增靈活性。
奎芯科技皆在推動開放生態的一站式Chiplet服務平臺,提供介面IP,Chiplet,系統設計和先進封裝設計等服務,配套强大的供應鏈資源及高效的系統綜合服務,為客戶提供完整的一站式解決方案。